ZHCAB20 November 2020 LM61460-Q1 , LM63615-Q1 , LM63625-Q1 , LM63635-Q1 , LMR33620-Q1 , LMR33630-Q1
4 封装类型
封装类型对热性能具有重大影响。在下面的讨论中,封装分为两大类:底部有裸片附接焊盘 (DAP) 的封装和底部无 DAP 的封装。当然,不同封装之间还有更多的区别和其他重要功能的差异,但从散热角度来看,这一区别最为重要。例如,LMR33630 可同时采用 HSOIC 和倒装芯片(或 HotRod™)QFN 封装,如图 4-1 所示。
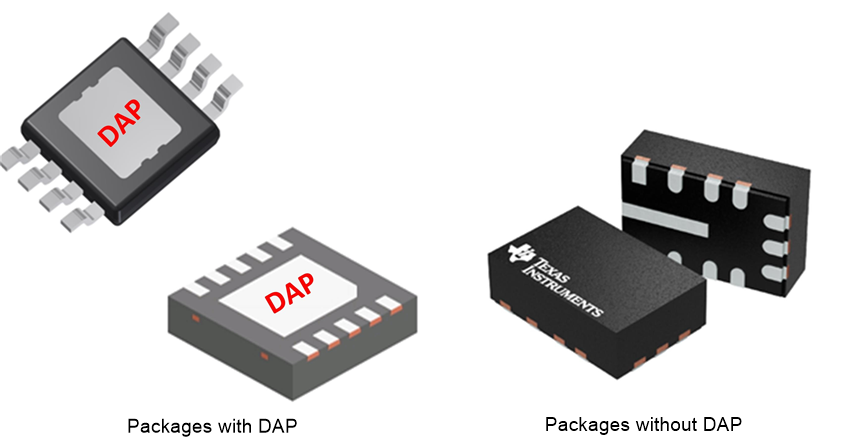 图 4-1 LMR33630-Q1 封装类型.
图 4-1 LMR33630-Q1 封装类型. 对于该系列器件,图 4-2 显示了两种封装之间 θJA 的差异。这些值基于 JEDEC 标准板,很明显,HSOIC 封装的热阻低得多。不利之处也是显而易见的;在本例中,HSOIC 封装的面积是倒装芯片 QFN 面积的三倍以上。与完全暴露引脚的较大封装相比,将 QFN 封装组装到 PCB 时需要更加小心。图 4-3 和图 4-4 帮助解释了这两个示例封装之间的热阻差异。HSOIC 具有一个直接附接到稳压器裸片的大金属散热板(即 DAP)。相应地,DAP 被焊接到 PCB 铜散热器上。这提供了从裸片(热发生器)到散热器和外部环境的一种非常低的热阻路径。因此,大约 80% 的热量流经 DAP,20% 流经引线,而极少的热量流经塑料。这使得 DAP(通常为电气接地)下的铜能够非常有效地散去封装中的热量。
使用倒装芯片封装时,裸片(或基板)背面朝上,远离 PCB。到 PCB 的唯一金属连接是通过封装引脚实现的。这迫使热量通过一种非常受限的路径流动,并会增加有效热阻。这还表明,到引脚的铜路径应尽可能发挥作用,以便充当散热器。对于直流/直流转换器而言,VIN、GND 和 SW 引脚在散热方面最为有效,应使其较宽。
当然,这些只是设计人员可用的电源封装类型的两个示例。TI 提供的许多封装类型同时具有良好的热性能和小尺寸优点。例如,符合汽车类标准的 LM63635-Q1。该器件采用 3.00mm x 3.00mm 的小型 WSON 封装,带有 DAP;可提供与大得多的封装相当的性能。
请注意,JEDEC 标准板过于强调了倒装芯片 QFN 和 HSOIC 之间的差异。在许多实际应用中,这两种封装之间的总 θJA 值是可以相比的。倒装芯片 QFN 与带有 DAP 的封装相比,将需要更多的 PCB 铜面积。在任何情况下,如前所述,表中给出的 θJA 值不会用于设计目的。
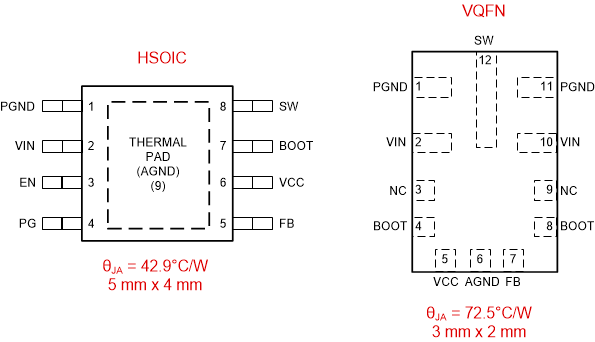 图 4-2 HSOIC 和 VQFN 封装性能比较.
图 4-2 HSOIC 和 VQFN 封装性能比较. 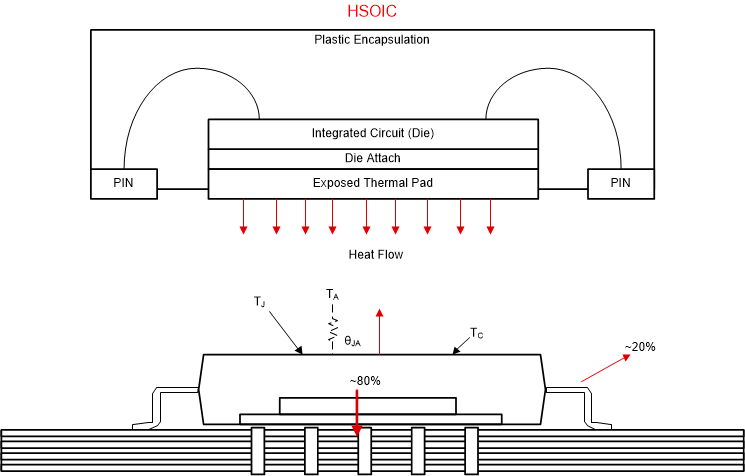 图 4-3 HSOIC 封装中的典型热流.
图 4-3 HSOIC 封装中的典型热流. 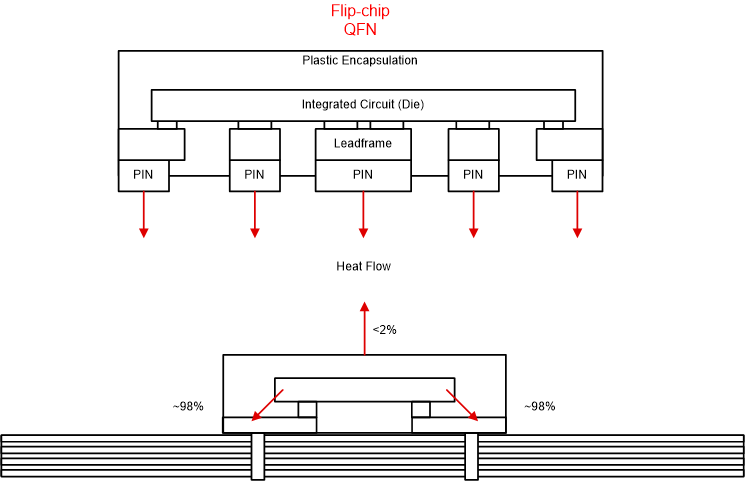 图 4-4 VQFN 封装中的典型热流.
图 4-4 VQFN 封装中的典型热流.