ZHCSQE7 august 2023 DRV8213
PRODUCTION DATA
- 1
- 1 特性
- 2 应用
- 3 说明
- 4 修订历史记录
- 5 器件比较
- 6 引脚配置和功能
- 7 规格
- 8 详细说明
- 9 应用和实施
- 10电源相关建议
- 11布局
- 12器件和文档支持
- 13机械、封装和可订购信息
封装选项
机械数据 (封装 | 引脚)
散热焊盘机械数据 (封装 | 引脚)
订购信息
9.2.1.5 热性能
数据表指定的结至环境热阻 RθJA 主要用于比较各种驱动器或者估算热性能。不过,实际系统性能可能比此值更好或更差,具体情况取决于 PCB 层叠、布线、过孔数量以及散热焊盘周围的铜面积。驱动器驱动特定电流的时间长度也会影响功耗和热性能。本节介绍了如何设计稳态和瞬态温度条件。
本节中的数据是按如下条件仿真得出的:
WSON(DSG 封装)
- 2 层 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),标准 FR4,1oz(35mm 铜厚度)或 2oz 铜厚度。散热过孔仅存在于散热焊盘下方(2 个过孔,1.2mm 间距,0.3mm 直径,0.025mm 铜镀层)。
- 顶层:DRV8213 WSON 封装尺寸和铜平面散热器。顶层覆铜区在仿真中有所不同。
- 底层:接地层通过 DRV8213 的散热焊盘下方的过孔进行热连接。底层铜面积随顶层铜面积而变化。
- 4 层 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),标准 FR4。外侧平面具有 1oz(35mm 覆铜厚度)或 2oz 覆铜厚度。内侧平面保持在 1oz。散热过孔仅存在于散热焊盘下方(2 个过孔,1.2mm 间距,0.3mm 直径,0.025mm 铜镀层)。
- 顶层:DRV8213 WSON 封装尺寸和铜平面散热器。顶层铜面积在模拟中有所不同。
- 中间层 1:GND 平面通过过孔热连接至 DRV8213 散热焊盘。接地平面的面积为 74.2mm x 74.2mm。
- 中间层 2:电源平面,无热连接。电源平面的面积为 74.2mm x 74.2mm。
- 底层:接地层通过来自顶部和内部 GND 平面的过孔拼接进行热连接。底层铜面积随顶层铜面积而变化。
图 9-10 展示了 DSG 封装的模拟电路板示例。表 9-3 显示了每次仿真时使用的不同板尺寸。
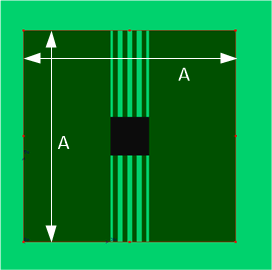 图 9-10 WSON PCB 模型顶层
图 9-10 WSON PCB 模型顶层表 9-3 用于 8 引脚 DSG 封装的尺寸 A
| 铜面积(mm2) | 尺寸 A(mm) |
|---|---|
| 2 | 15.11 |
| 4 | 20.98 |
| 8 | 29.27 |
| 16 | 40.99 |
WQFN(RTE 封装)
- 2 层 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),标准 FR4,1oz(35mm 铜厚度)或 2oz 铜厚度。散热过孔仅存在于封装尺寸下方(5 个过孔,1mm 间距,0.2mm 直径,0.025mm 铜镀层)。
- 顶层:WQFN 封装尺寸和布线。
- 底层:接地层通过封装尺寸下的过孔进行热连接。底层覆铜区在仿真中有所不同。
- 4 层 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),标准 FR4。外侧平面具有 1oz(35mm 覆铜厚度)或 2oz 覆铜厚度。内侧平面保持在 1oz。散热过孔仅存在于封装尺寸下方(5 个过孔,1mm 间距,0.2mm 直径,0.025mm 铜镀层)。
- 顶层:WQFN 封装尺寸和布线。
- 中间层 1:GND 平面通过过孔在封装尺寸下进行热连接。接地平面的面积为 74.2mm x 74.2mm。
- 中间层 2:电源平面,无热连接。电源平面的面积为 74.2mm x 74.2mm。
- 底层:带有小型铜焊盘的信号层,位于驱动器下方,通过来自顶部和内部 GND 平面的过孔拼接进行热连接。底层散热焊盘的尺寸与封装相当 (3 mm x 3 mm)。底部焊盘的尺寸保持不变。
图 9-11 展示了 WQFN 封装的模拟电路板示例。表 9-4 显示了每次仿真时使用的不同板尺寸。
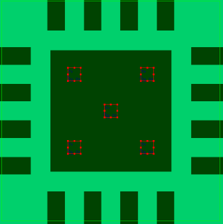 图 9-11 WQFN PCB 模型顶层
图 9-11 WQFN PCB 模型顶层表 9-4 用于 16 引脚 RTE 封装的尺寸 A
| 铜面积 (cm2) | 尺寸 A(mm) |
|---|---|
| 2 | 14.14 |
| 4 | 20.00 |
| 8 | 28.28 |
| 16 | 40.00 |