ZHCAA86A October 2020 – February 2021 LMG3422R030 , LMG3422R050 , LMG3425R030 , LMG3425R050
2 新型 QFN 12x12 封装
图 2-1新开发的 QFN 12x12 是一种小型、无引线的表面贴装封装,其底面有一个裸露的铜 (Cu) 散热焊盘和功能引脚,如 中所示。它保持了与先前的 QFN 8x8 封装解决方案(用于 TI 的 600V GaN 功率级产品)相同的电气特性和功能集成。改进的封装热设计改善了功率耗散水平,并通过这一更新的 QFN 12x12 配置实现。
 图 2-1 QFN 12x12 封装外观 (12mm x 12mm x
0.9mm)
图 2-1 QFN 12x12 封装外观 (12mm x 12mm x
0.9mm)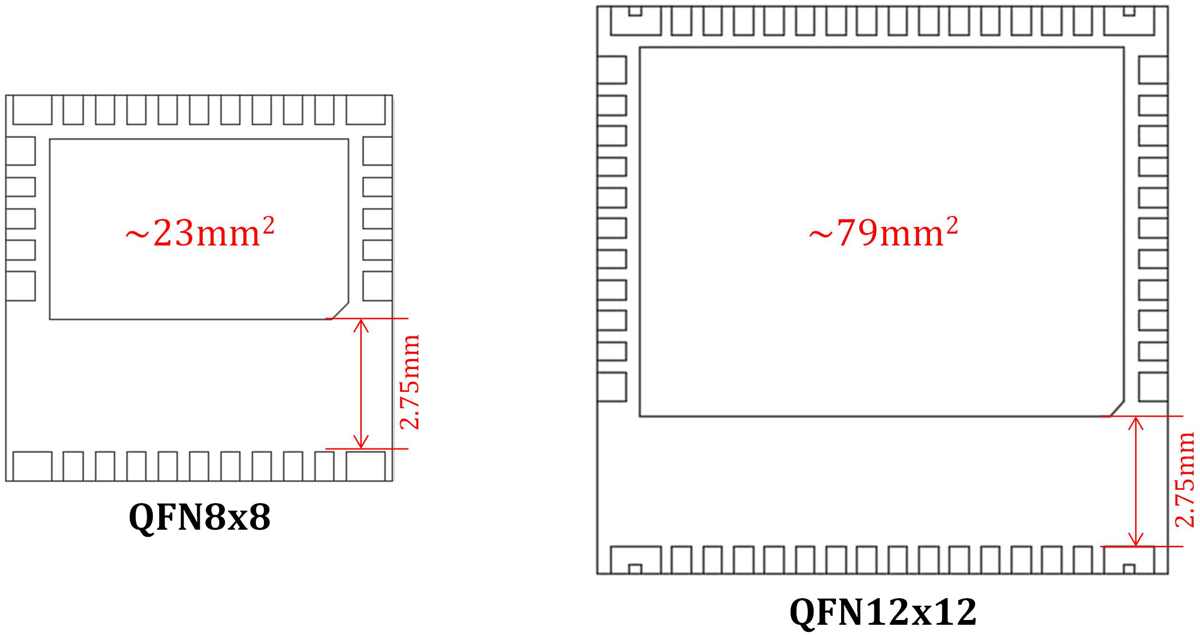 图 2-2 封装底面上引脚配置的比较
图 2-2 封装底面上引脚配置的比较图 2-2 显示了 QFN 12x12 封装,与先前的 QFN 8x8 版本相比,该封装的散热焊盘面积大 3 倍,但中心散热焊盘(在内部连接到电源)与底部漏极端子引脚之间的爬电距离仍为 2.75mm。表 2-1 比较了 TI 的 QFN 和其他常用表面贴装封装(用于高电压 GaN 或碳化硅 (SiC) 分立式器件的 TO 无引线 (TOLL) 和 D2PAK)的封装面积和散热焊盘面积。与竞争对手的封装相比,TI 的 QFN 12x12 封装的裸露散热焊盘面积最大,为 79mm2。虽然该封装在印刷电路板 (PCB) 上占据的空间比 TOLL 封装大,但其散热焊盘面积与 PCB 封装面积之比比 TOLL 封装高 7%,因此它所包含的通过底面冷却系统散热的有效面积更大。
表 2-1 不同封装的封装面积和散热焊盘面积比较
| 制造商 | TI | TI | 竞争对手 A | 竞争对手 B |
|---|---|---|---|---|
| 封装 | QFN 8x8 | QFN 12x12 | TOLL1 | D2PAK2 |
| PCB 上的最小封装面积 (mm2) | 64 | 144 | 116 | 165 |
| 裸露散热焊盘面积 (mm2) | 23 | 79 | 56 | 45 |
| 散热焊盘面积/PCB 封装面积 (%) | 36 | 55 | 48 | 27 |
- 600V GaN HEMT
- 650V SiC MOSFET