ZHCAA86A October 2020 – February 2021 LMG3422R030 , LMG3422R050 , LMG3425R030 , LMG3425R050
3.1 封装热性能参数 RθJC/P 的定义
图 3-1
描绘了从器件结到环境的两条平行热流路径,并给出了相应的一维热阻 (Rθ) 电路模型。表 3-1图 3-1 对 中所示和本报告讨论的各种 Rθ
参数进行了说明。底面冷却的 QFN 12x12 封装设计为主要通过热界面材料 (TIM) 以及与环境相连的散热器从基体 PCB
中散热。在这种典型的底面冷却配置中,从封装顶部散发到环境中的热量极少。底部路径的效率越高,从顶部散发的能量就越少。
Equation1因此, 可使用 对一种高效率底面冷却系统的
RθJA进行估算:
RθJC(bot 或 top),定义为在器件结与封装表面之间用于散热的热阻,通常在制造商的数据表中给出。然而,在某些情况下,使用这个参数直接比较封装的热性能会带来误导,特别是对于不同类型的封装。例如,当采用 D2PAK 封装时,同一个 600V Si MOSFET 的 RθJC(bot) 值可能为 0.8°C/W,但采用 QFN 8x8 封装时此参数的值为 0.6°C/W,原因在于 D2PAK 具有更厚的铜片。这并不意味着 QFN 8x8 封装在热性能方面比 D2PAK 更好。通过增加封装热阻 RθJC(bot),在 D2PAK 封装中使用较厚的铜片进行裸片连接,可以在热流到达 PCB 顶部铜层之前在封装内部实现更均匀的热量分布。此外,热片较大也使系统设计人员能够在 PCB 上增加更多的铜焊盘面积和散热过孔,以降低其热阻。PCB 上的散热更有效,因此 RθTIM 会随之降低。因此,通过提高现有冷却元件的效率和/或采用更有效的散热解决方案,在散热方面设计良好的封装有助于提供系统级别的功率耗散能力,这一点非常重要。对于底面冷却的表面贴装封装,其热性能不可避免地与安装板(以及附着的 TIM,如果使用)相耦合。Equation2为了更好地定义和比较不同封装的热性能,在以下章节中使用了一个实用指标 RθJC/P(即从器件结到主冷却平面的热阻),其定义请参阅:
Equation2对于此定义, 中不包括 RθH/S 或 RθColdplate,因为它们独立于器件封装设计,更多地取决于其自身特性(如材料和结构)和其他使用条件(如空气/冷却剂流速)。
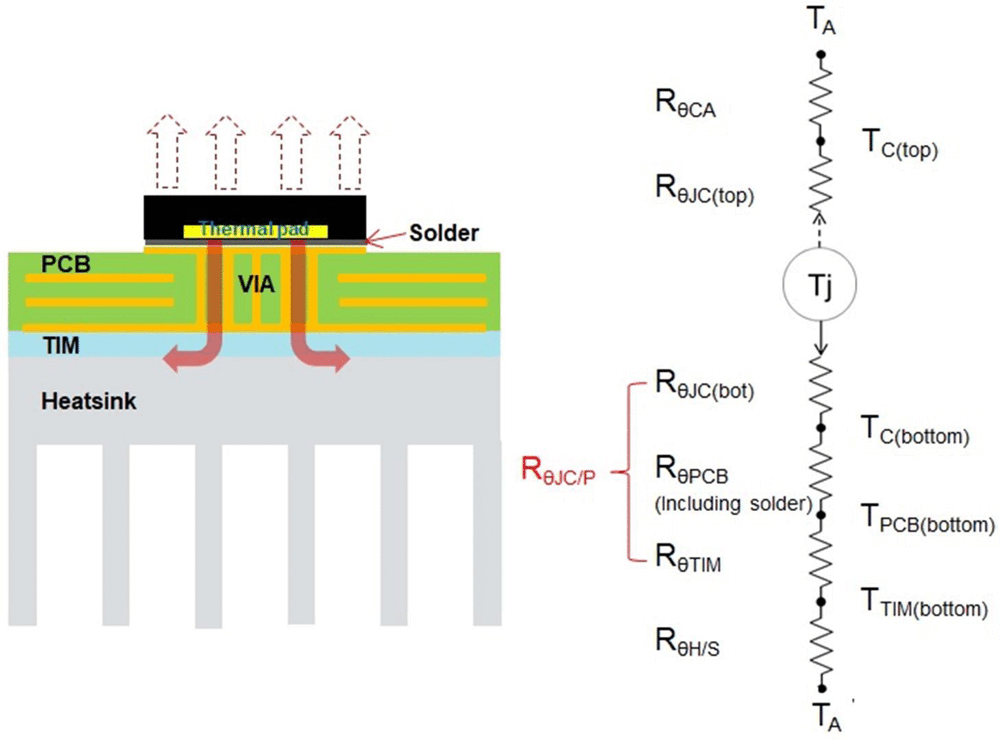 图 3-1 带底部散热焊盘的表面贴装器件的典型冷却设计
图 3-1 带底部散热焊盘的表面贴装器件的典型冷却设计| 符号 | 说明 |
|---|---|
| RθJA | 结至环境热阻 |
| RθJC(top) | 结至外壳(顶部)热阻 |
| RθJC(bot) | 结至外壳(底部)热阻 |
| RθCA | 外壳至环境热阻 |
| RθJC/P | 结至冷却平面热阻 |
| RθPCB | PCB(包括焊料层)的热阻 |
| RθTIM | 热界面材料 (TIM) 的热阻 |
| RθH/S | 散热器的热阻 |