ZHCSUM8J September 2008 – August 2025 TL720M05-Q1
PRODMIX
封装选项
请参考 PDF 数据表获取器件具体的封装图。
机械数据 (封装 | 引脚)
- KVU|3
- PWP|20
- KTT|3
散热焊盘机械数据 (封装 | 引脚)
订购信息
8.1.4.1 热性能与铜面积
最常用的热阻 (RθJA) 在很大程度上取决于特定 PCB 设计中内置的散热能力。因此,RθJA 会根据总铜面积、铜重量和平面位置而变化。节 5.4表中记录的 RθJA 由 JEDEC 标准(参阅图 8-1)、PCB 和铜扩散面积决定。RθJA 仅用作封装热性能的相对测量值。对于精心设计的热布局,RθJA 实际上是 RθJCbot 与 PCB 铜产生的热阻的总和。RθJCbot 是封装结至外壳(底部)热阻。
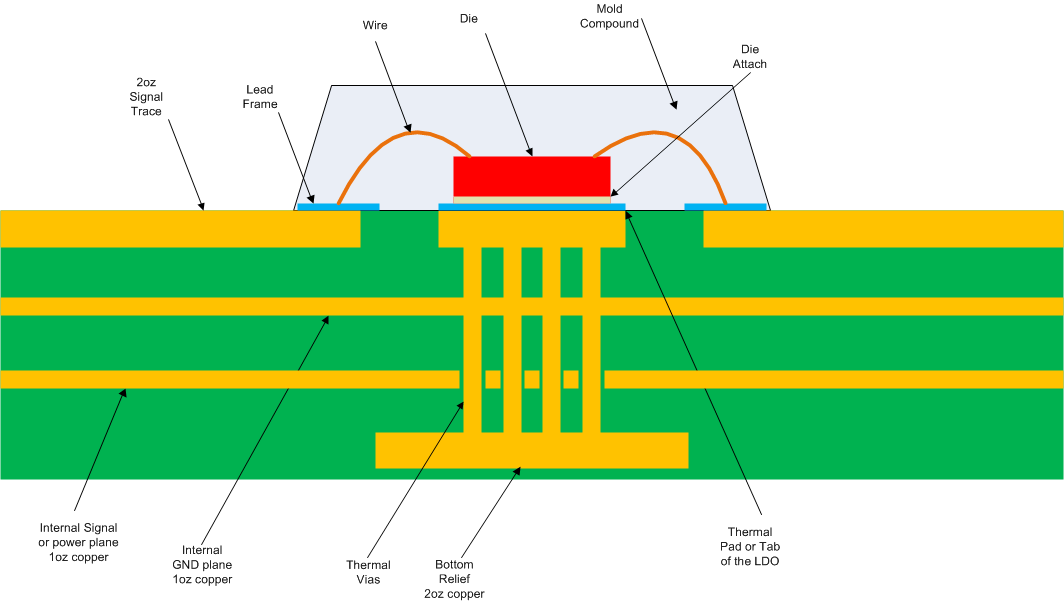 图 8-1 JEDEC 标准 2s2p PCB
图 8-1 JEDEC 标准 2s2p PCB图 8-2 和图 8-3 展示了 RθJA 和 ψJB 的功能与铜面积和厚度的关系。这些图是使用 101.6mm × 101.6mm × 1.6mm 两层和四层 PCB 生成。对于 4 层板,内部平面使用 1oz 厚度的覆铜。外层均使用 1oz 和 2oz 铜厚度进行模拟。一个 3 × 4(KVU 封装)阵列的热通孔具有 300µm 钻孔直径和 25µm 镀铜,位于器件散热焊盘下方。散热通孔连接顶层和底层,如果是 4 层板,则连接第一个内部 GND 平面。每一层都有一个面积相等的铜平面。
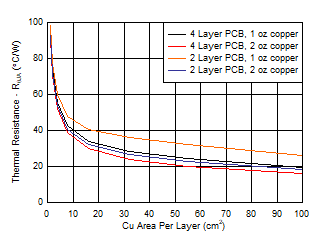 图 8-2 RθJA 与铜面积间的关系(KVU 封装)
图 8-2 RθJA 与铜面积间的关系(KVU 封装) 图 8-3 ψJB 与铜面积(KVU 封装)
图 8-3 ψJB 与铜面积(KVU 封装)