ZHCSID9E September 2006 – October 2016 TLC082-Q1 , TLC084-Q1
PRODUCTION DATA.
11.1.1 通用 PowerPAD™ 设计注意事项
TLC08x-Q1 采用热增强型 PowerPAD 系列封装。这些封装使用下行引线框构建,裸片安装在此引线框上 [请参阅Figure 48(a) 和 Figure 48(b)]。这种布置会导致引线框暴露为封装底面上的散热垫 [请参阅 Figure 48(c)]。由于散热垫与裸片发生直接热接触,因此通过散热垫提供的良好散热路径可实现出色的散热性能。
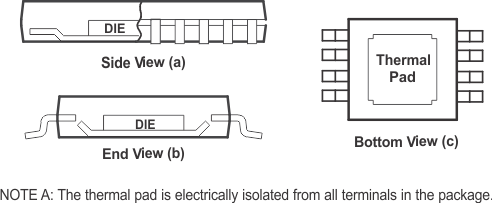 Figure 48. 热增强型 DGN 封装视图
Figure 48. 热增强型 DGN 封装视图 借助 PowerPAD 封装,一次生产操作即可实现组装管理和散热管理。在表面贴装焊接操作(焊接引线时)中,必须将散热垫焊接在封装底面上的覆铜区域内。通过在此覆铜区域内使用散热路径,可将封装上的热量传递到接地平面或其他散热器件上。
NOTE
务必需要将散热垫焊接到 PCB 上,即使对于功率损耗较低的 应用 也是如此。
此焊接在引线框裸片垫和 PCB 之间提供必需的散热和机械连接。虽然有很多适用的方法可为 PowerPAD 封装散热,但以下步骤列出了推荐方法。
必须将散热垫连接至器件的最负性电源电压(GND 引脚电势)。
- 用顶面蚀刻方式准备 PCB(请参阅此数据表结尾的焊盘布局)。应对引线进行蚀刻,还要对散热垫进行蚀刻。
- 在散热垫区域内布置 5 个孔(双路)或 9 个孔(四路)。这些孔的直接应为 13 密耳。确保小孔径,保证在回流过程中这些孔可以正常渗锡。
- 可能需要在散热垫区域外沿散热平面的任意位置布置额外的通孔。这有助于耗散 TLC08x-Q1 器件产生的热量。这些额外通孔可能大于散热垫下方直径为 13 密耳的通孔。这些通孔的面积可能更大,因为它们不在要焊接的散热垫区域内,因此渗锡不是问题。
- 将所有孔连接到内部平面,该平面与器件接地引脚的电势相同。
- 将这些孔连接到此内部平面时,请勿使用典型网络或通过连接方法。网络连接具有高热阻连接,这对于减慢焊接作业中的热传递非常有用。这简化了具有平面连接的通孔的焊接操作。然而,在这种应用中,最高效的热传递需要低热阻。因此,TLC08x-Q1 PowerPAD 封装下的孔应连接到内部接地平面,该平面在整个通孔一周具有完整连接。
- 顶面阻焊层应使封装端子和具有 5 孔(双路)或 9 孔(四路)的散热垫区域处于暴露状态。底面阻焊层应覆盖散热垫区域的 5 个或 9 个孔。这样可以防止回流过程中焊料从散热垫区域流走。
- 将焊锡膏涂抹在暴露的散热垫区域内和所有 IC 端子上。
- 这些准备过程完成后,即可将 TLC08x-Q1 IC 放置就位,然后像针对所有标准表面贴装元件那样实施焊料回流操作。这样可保证元件正常安装。
对于给定 RθJA,请使用Equation 1 计算最大功率损耗。

下一个注意事项是封装限制。放大器内的两个热量来源是静态功率和输出功率。设计人员应谨记器件内会产生静态热量,对于多放大器器件更是如此。因为这些器件具有线性输出级(A-B 级),大多数散热发生在低输出电压和高输出电流时。
解决功率损耗的另一个关键因素是如何在 PCB 上安装器件。PowerPAD 器件对散热非常有用。但是,务必应将器件焊接在覆铜平面上,以充分利用散热垫的散热属性。另一方面,SOIC 封装在很大程度上取决于在 PCB 上的安装方式。由于在器件周围布置了更大的线迹区域和覆铜区域,因此 RθJA 减小,散热功能降低。典型特性 中显示的电流和电压是针对总封装的。对于双路或四路放大器封装,应利用 RMS 输出电流和电压的总和来选择合适的封装。