SBAA222A October 2017 – April 2025 ADS1282-SP
6 SET Test Results
A SET event is defined as the duration when the absolute value of the (sample – reference) is greater than the mask threshold [6]. As an example, if ten consecutive samples exceed the reference sample by greater than the mask threshold, then this is one error event and ten errors. The number of error events were used to determine the number of transients collected until the run is stopped [6].
SET testing was performed with AVDD set to 4.75V and DVDD set to 1.7V. Figure 6-1 shows the cross-section for register upsets. Weibull fit parameters are shown in Table 6-1.
| PARAMETER | VALUE | |||
|---|---|---|---|---|
| LETth (MeV × cm2/mg) | 1.4 | |||
| σ sat (cm2) | 1.3E–05 | |||
| Width, W (MeV × cm2/mg) | 15 | |||
| Exponent, s | 1.4 | |||
Table 6-2 lists the runs and test conditions as well as the result of the runs for DUT serial numbers 11 and 14. Note the DUT board with serial number 14 was configured with the bypass pin connected directly to DVDD.
| Run | SN | Ion | LETeff (MeV × cm2/mg) | Effective Fluence (ion/cm2) | AVDD (Volts) | DVDD (Volts) | Config | Errors | Error Events | DRDY_N Errors | Comments |
|---|---|---|---|---|---|---|---|---|---|---|---|
| 26 | 11 | Ag at 0° | 42.8 | 9.65E+05 | 4.75 | 3 | AIN1 | 6306 | 400 | 2455 | |
| 27 | 11 | Ag at 0° | 42.8 | 9.75E+05 | 4.75 | 3 | AIN2 | Configuration Registers Reset | |||
| 28 | 11 | Ag at 0° | 42.8 | 1.02E+06 | 5.25 | 3 | AIN1 | 5593 | 183 | 1661 | |
| 29 | 11 | Ag at 0° | 42.8 | 9.44E+05 | 5.25 | 3 | AIN2 | Configuration Registers Reset | |||
| 38 | 11 | Xe at 0° | 52.3 | 1.03E+06 | 5.25 | 3 | AIN1 | 6679 | 222 | 1323 | |
| 49 | 14 | Xe at 0° | 52.3 | 1.05E+06 | 4.75 | 1.7 | AIN1 | 4288 | 176 | 4308 | |
| 50 | 14 | Xe at 0° | 52.3 | 9.85E+05 | 4.75 | 1.7 | AIN2 | Configuration Registers Reset | |||
| 51 | 14 | Ar at 0° | 8.4 | 9.67E+05 | 4.75 | 1.7 | AIN1 | 6269 | 58 | 134 | |
| 52 | 14 | Ar at 0° | 8.4 | 1.06E+06 | 4.75 | 1.7 | AIN2 | Configuration Registers Reset | |||
| 53 | 14 | Ne at 0° | 2.7 | 1.02E+06 | 4.75 | 1.7 | AIN1 | 1 | 1 | 0 | |
| 54 | 14 | Ne at 0° | 2.7 | 1.03E+06 | 4.75 | 1.7 | AIN2 | 4 | 4 | 0 | No Configuration Registers Reset |
| 55 | 14 | Kr at 0° | 28.3 | 1.00E+06 | 4.75 | 1.7 | AIN1 | 3746 | 364 | 1010 | |
| 56 | 14 | Kr at 0° | 28.3 | 1.01E+06 | 4.75 | 1.7 | AIN2 | Configuration Registers Reset |
 Figure 6-1 Cross-Section for Register Upsets
Figure 6-1 Cross-Section for Register UpsetsTo disambiguate noise from bit errors, the least significant bits of the data conversion output were masked until no error events were observed under no irradiation. The ion beam was subsequently turned on, and the output was observed until the specified number of transients were recorded or the fluence reached 106 ions/cm2.
During SEL testing and during some of the SET runs, single-event functional interrupts (SEFI) were observed, which required the device to be reset to restore functionality. Cross-section data on this error mode cannot be calculated with any confidence as the device reset under irradiation and some SEFI may clear before they are detected. At the same time, runs that exhibited a SEFI mode would inhibit the collection of further SET and thus will underestimate the error cross section [6].
To avoid confounding of multiple error sources, the test runs in which register SEU’s were observed were excluded when calculating the SET cross section. Figure 6-2 shows the resulting cross section, and the Weibull fit parameters are listed in Table 6-3.
| PARAMETER | VALUE | |||
|---|---|---|---|---|
| LETth (MeV × cm2/mg) | 2.7 | |||
| σ sat (cm2) | 3.7E–04 | |||
| Width, W (MeV·cm2/mg) | 27 | |||
| Exponent, s | 0.9 | |||
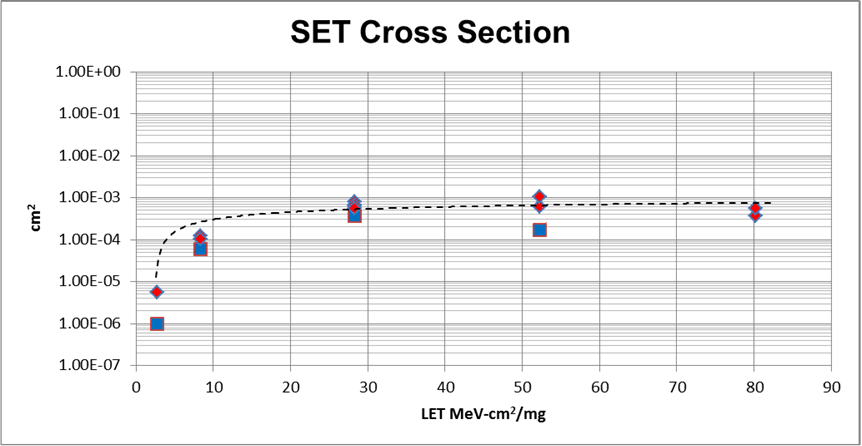 Figure 6-2 SET Cross Section
Figure 6-2 SET Cross Section