ZHCSMT2N July 2001 – January 2025 TPS793
PRODUCTION DATA
7.5.1.2 功率耗散
不同封装类型的芯片散热能力是不同的,在印刷电路板 (PCB) 布局过程中应区别对待。器件周围没有其他组件的 PCB 区域会将器件的热量散发到周围空气中。热性能信息 表中列出了 JEDEC 低 K 电路板和高 K 电路板的性能数据。使用较重的覆铜可提高器件的散热效率。此外,在散热层添加镀层穿孔也可以提高散热效率。
功耗取决于输入电压和负载情况。功率耗散 (PD) 等于输出电流乘以输出导通元件(VIN 至 VOUT)上的压降所得到的乘积,如方程式 4 所示。
其中:
- TJmax 是允许的最大结温。
- RθJA 是封装的结至环境热阻。
- TA 为环境温度。
方程式 4. 

静态电流导致的功率耗散可以忽略不计。过多功率耗散会触发过热保护电路。
图 7-8 展示了 TPS730 的最高环境温度与功率耗散之间的关系。该图假设器件焊接在 JEDEC 标准高 K 布局上,电路板上没有气流。电路板的实际热阻抗差异很大。如果应用需要高功率耗散,则透彻了解电路板温度和热阻抗有助于验证 TPS730 在高于 125°C 结温的情况下是否无法运行。
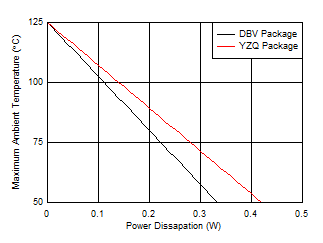 图 7-8 最高环境温度与功率耗散间的关系
图 7-8 最高环境温度与功率耗散间的关系可以通过使用热性能信息 表中所示的热指标 ψJT 和 ψJB 来估算结温。与 RθJA 相比,这些指标是芯片和封装热传递特性的更准确表示。可以使用方程式 5 来估算结温。
方程式 5. 

其中
- PD 是耗散功率,如方程式 4 所示。
- TT 是 IC 封装顶部中间位置的温度。
- TB 是在 PCB 表面 距 IC 封装 1mm 测得的 PCB 温度。
注:
TT 和 TB 都可以使用实际测温仪(红外温度计)在实际应用板上进行测得。
有关测量 TT 和 TB 的详细信息,请参阅使用新的热指标 应用手册 (SBVA025),该应用手册可从 www.ti.com 下载。