ZHCT404A may 2020 – may 2020 LM61460-Q1
2 使用倒装芯片封装管理热量
无论降压转换器的效率如何,功率级都会产生损耗。电源转换器损耗会导致器件结温升高,从而妨碍在较高环境温度下的安全运行。针对高环境温度的转换器设计需要适当的热管理,以确保不超过转换器的建议最大额定结温,从而防止转换器使相邻器件升温。
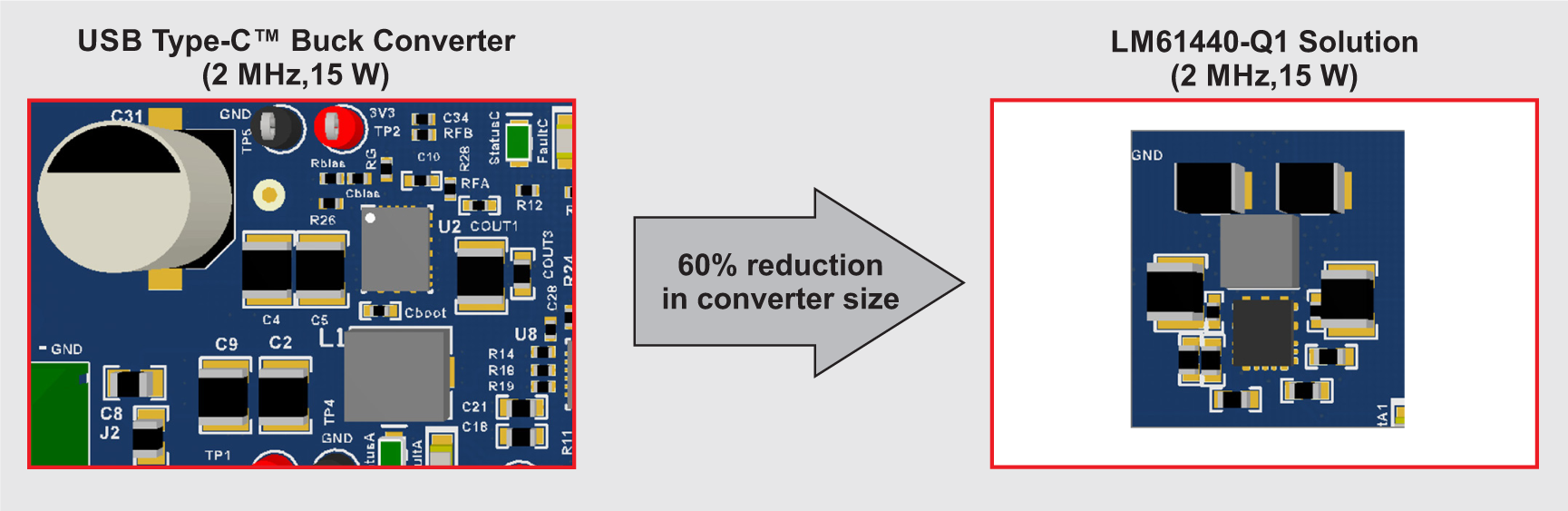 图 1 使用 LM61440-Q1 降压转换器减小解决方案面积
图 1 使用 LM61440-Q1 降压转换器减小解决方案面积许多半导体制造商正在采用倒装芯片封装设计来实现转换器。倒装芯片器件通常采用 Quad Flat No-lead (QFN) 封装,在半导体芯片与引线框之间实现低电感连接。这在热性能和噪声性能之间实现了良好的平衡。但是,封装的底部可能没有散热焊盘,这会降低其散热效率。不过,对于倒装芯片器件,可以通过芯片与引线框之间的铜连接实现高效的热传导(图 2 和图 3)。
为了避免温度过度升高,有必要提供一条从着陆焊盘远离器件的高导热路径。连接到器件焊盘的宽引线可以在元件层中实现散热。密集的 PCB 布局会阻碍元件层有效散热,尤其是对于低效(高温)相邻器件。如图 3 所示,各个内层的散热通常比元件层的散热更有效。如果将散热过孔连接到已连接到器件电源或回路引脚的铜上,则可以实现散热。然后,这些通孔将连接到 IC 下方的铜平面,从而增加有效的铜散热面积。在放置过孔时,务必最大程度地减少热瓶颈,同时为电源引脚提供最高的过孔数量和最低的热阻(图 2)。
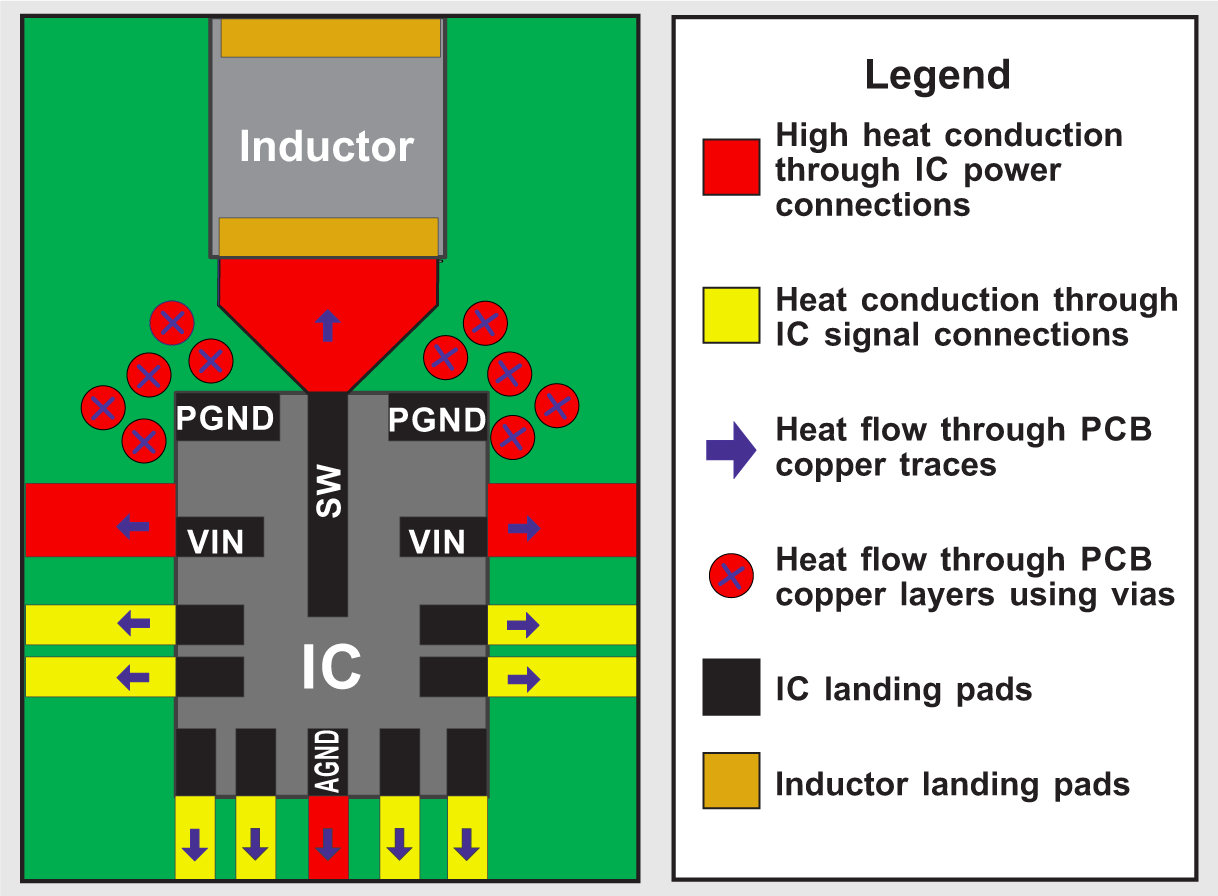 图 2 用于 PCB 层散热的倒装芯片内核到封装热传导路径的顶视图
图 2 用于 PCB 层散热的倒装芯片内核到封装热传导路径的顶视图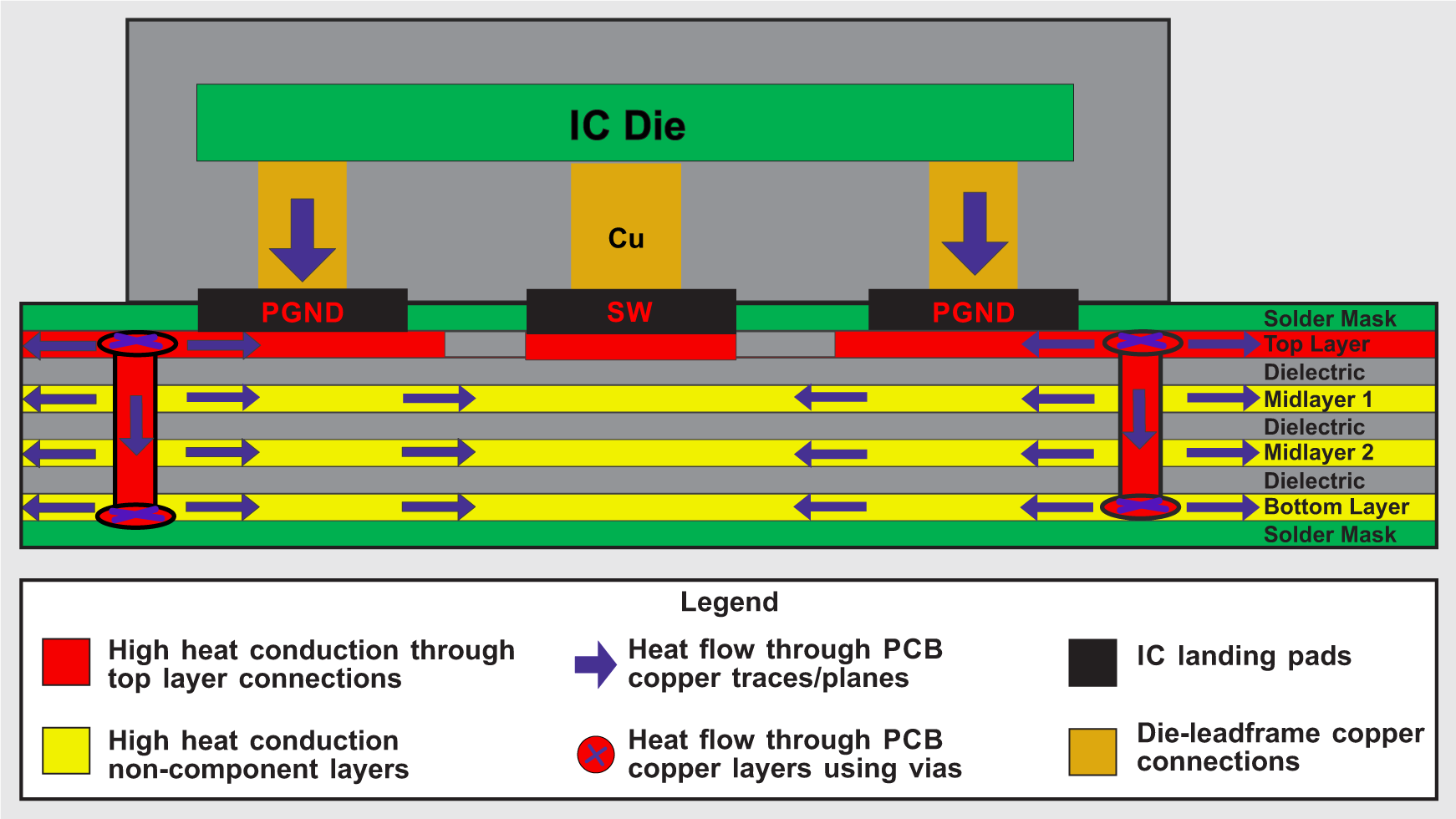 图 3 倒装芯片内核到封装热传导路径的电路板层视图
图 3 倒装芯片内核到封装热传导路径的电路板层视图