ZHCSJO2F May 2019 – September 2025 TPS7B81-Q1
PRODUCTION DATA
封装选项
机械数据 (封装 | 引脚)
散热焊盘机械数据 (封装 | 引脚)
订购信息
7.1.1 功率耗散
电路可靠性需要适当考虑器件功率耗散、印刷电路板 (PCB) 上的电路位置以及正确的热平面尺寸。稳压器周围的 PCB 区域必须尽量消除其他会导致热应力增加的发热器件。
对于一阶近似,稳压器中的功率耗散取决于输入到输出电压差和负载条件。可使用 方程式 1 来计算 PD:
需要注意的一点是,通过适当选择系统电压轨,可更大限度地降低功率耗散,从而实现更高的效率。通过适当的选择,可以获得最小的输入到输出电压差。器件的低压降有助于在宽输出电压范围内实现出色效率。
器件的主要热传导路径是通过封装上的散热焊盘。因此,必须将散热焊盘焊接到器件下方的铜焊盘区域。此焊盘区域包含一组镀通孔,可将热量传导到任何内部平面区域或底部覆铜平面。
最大功耗决定了该器件允许的最高结温 (TJ)。根据 方程式 2,功率耗散和结温通常与 PCB 和器件封装组合的结至环境热阻 (RθJA) 和环境空气温度 (TA) 有关。该公式重新排列后可得到输出电流(如方程式 3 所示)。
遗憾的是,此热阻 (RθJA) 在很大程度上取决于特定 PCB 设计中内置的散热能力,因此会因铜总面积、铜重量和平面位置而异。表中记录的 RθJA 由 JEDEC 标准 PCB 和铜扩散面积决定,仅用作封装热性能的相对测量。请注意,对于精心设计的热布局,RθJA 实际上是封装结至外壳(底部)热阻 (RθJCbot) 与 PCB 铜产生的热阻的总和。
图 7-1 至 图 7-6 展示了 RθJA 和 ψJB 的功能与铜面积和厚度的关系。这些图是使用 101.6mm × 101.6mm × 1.6mm 两层和四层 PCB 生成。对于四层板,内部平面使用 1oz 厚度的覆铜。外层均使用 1oz 和 2oz 铜厚度进行模拟。该器件的散热焊盘下方设有一个 2 × 1 阵列的散热过孔,这些过孔的钻孔直径为 300µm,铜镀层厚度为 25µm。散热通孔连接顶层和底层,如果是 4 层板,则连接第一个内部 GND 平面。每一层都有一个面积相等的铜平面。
 图 7-1 WSON (DRV) 封装的 RθJA 与铜面积间的关系
图 7-1 WSON (DRV) 封装的 RθJA 与铜面积间的关系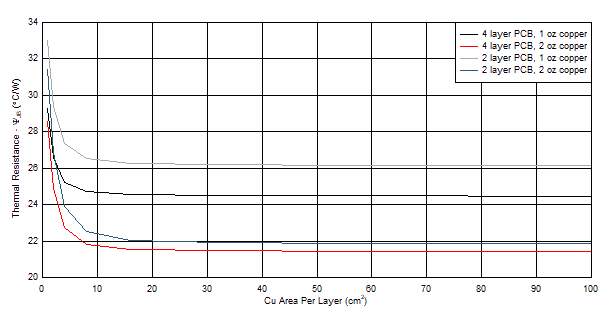 图 7-2 WSON (DRV) 封装的 ψJB 与铜面积间的关系
图 7-2 WSON (DRV) 封装的 ψJB 与铜面积间的关系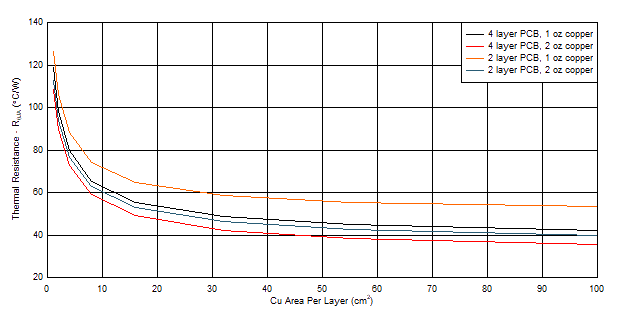 图 7-3 HVSSOP (DGN) 封装的 RθJA 与铜面积间的关系
图 7-3 HVSSOP (DGN) 封装的 RθJA 与铜面积间的关系 图 7-4 HVSSOP (DGN) 封装的 ψJB 与铜面积间的关系
图 7-4 HVSSOP (DGN) 封装的 ψJB 与铜面积间的关系 图 7-5 TO-252 (KVU) 封装的 RθJA 与铜面积间的关系
图 7-5 TO-252 (KVU) 封装的 RθJA 与铜面积间的关系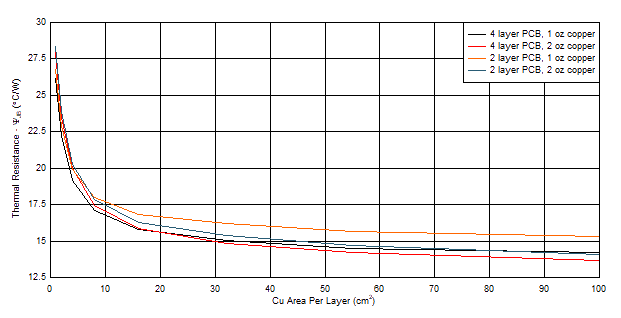 图 7-6 TO-252 (KVU) 封装的 ψJB 与铜面积间的关系
图 7-6 TO-252 (KVU) 封装的 ψJB 与铜面积间的关系