GERY013C january 2023 – april 2023 LMQ61460-Q1 , TPS54319 , TPS62088 , TPS82671 , UCC12040 , UCC12050
- Auf einen Blick
- Authors
- 3
- Was ist Leistungsdichte?
- Wodurch wird die Leistungsdichte begrenzt?
- Einschränkung der Leistungsdichte: Schaltverluste
- Begrenzungsfaktor Nr. 1: Ladungsbezogene Verluste
- Begrenzungsfaktor Nr. 2: Sperrverzögerungsverluste
- Begrenzungsfaktor 3: Verluste beim Ein- und Ausschalten
- Was schränkt Leistungsdichte ein: thermische Leistung
- Schwierigkeiten bei der Verbesserung der Leistungsdichte überwinden
- Innovationen zur Überwindung von Schaltverlusten
- Innovationen für die Thermik von Gehäusen
- Designinnovationen für erweiterte Schaltkreise
- Innovationen bei der Integration
- Fazit
- Weitere Ressourcen
Innovationen für die Thermik von Gehäusen
Die Fähigkeit, einem integrierten Schaltkreis (IC)-Gehäuse Wärme zu entziehen, wirkt sich direkt auf die Leistungsdichte aus. Wie bereits erwähnt, wird dieses Problem aufgrund der Verringerung der Gehäusegrößen in Anwendungen jeglicher Art immer wichtiger. Außerdem sind Halbleiter in typischen Stromkonverteranwendungen die Bauelemente, die sich am schnellsten erwärmen können, insbesondere dann, wenn der Rsp schnell sinkt.
TI hat in die Entwicklung von HotRod™™-Gehäusen investiert, in denen die typischen QFNs (Quad Flat No Leads-Gehäuse) mit Bond-Drähten durch ein Flip-Chip-Gehäuse ersetzt wurden. In Abbildung 9 und Abbildung 10 ist zu sehen, wie ein HotRod-QFN bei gleicher Fläche wie ein QFN ohne die Bonddrähte auskommt. Dies führt zu einer erheblichen Verringerung der für Flip-Chip-Gehäuse typischen parasitären Schleifeninduktivität, wobei einige der Vorteile der thermischen Leistung von QFN-Gehäusen erhalten bleiben. Im HotRod-QFN-Gehäuse besteht eine Verbindung zwischen Stanzgitter und Die.
 Abbildung 9 Standard-Bonddraht-QFN-Gehäuse
mit exponiertem Pad.
Abbildung 9 Standard-Bonddraht-QFN-Gehäuse
mit exponiertem Pad. Abbildung 10 HotRod-Verbindungsgehäuse
(Flip-Chip-on-Lead) im QFN-Gehäuse.
Abbildung 10 HotRod-Verbindungsgehäuse
(Flip-Chip-on-Lead) im QFN-Gehäuse.Eine der Herausforderungen, die bei der Verwendung von HotRod-Gehäusen auftritt, besteht darin, dass es schwieriger ist große Die-Attach-Pads (DAPs) zu bauen, die in der Regel sehr hilfreich bei der Verbesserung der Gehäuse-Thermik sind. Um diese Herausforderung zu meistern, hat TI seine HotRod-QFN-Gehäuse vor kurzem verbessert. So können die bestehenden Vorteile von QFN-Gehäusen genutzt werden und gleichzeitig große Gehäuse mit DAPs gebaut werden.
Abbildung 11, Abbildung 12 und Abbildung 14 zeigen den Synchronwandler LM60440 mit 4 A, bei dem mit der neuen Technologie das Wärmeverhalten verbessert werden konnte. Sie können erkennen, dass es in der Mitte des Gehäuses genug Platz für einen großen DAP gibt. Dieser DAP verkraftet einen um ca. 15% höheren Temperaturanstieg als die DAPs der vorherigen Generation. Weitere Informationen zur Entwicklung dieser Gehäuses finden Sie im Artikel unseres Analog Design Journal Entwicklung mit kleinen DC/DC-Wandlern:HotRod™ QFN- vs. Enhanced HotRod™ QFN-Gehäuse.
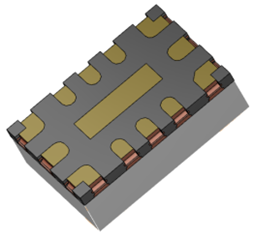 Abbildung 11 Verbessertes
HotRod-QFN-Gehäuse mit großem DAP.
Abbildung 11 Verbessertes
HotRod-QFN-Gehäuse mit großem DAP. Abbildung 12 Anschlussbelegung des LM60440
in Enhanced HotRod QFN.
Abbildung 12 Anschlussbelegung des LM60440
in Enhanced HotRod QFN.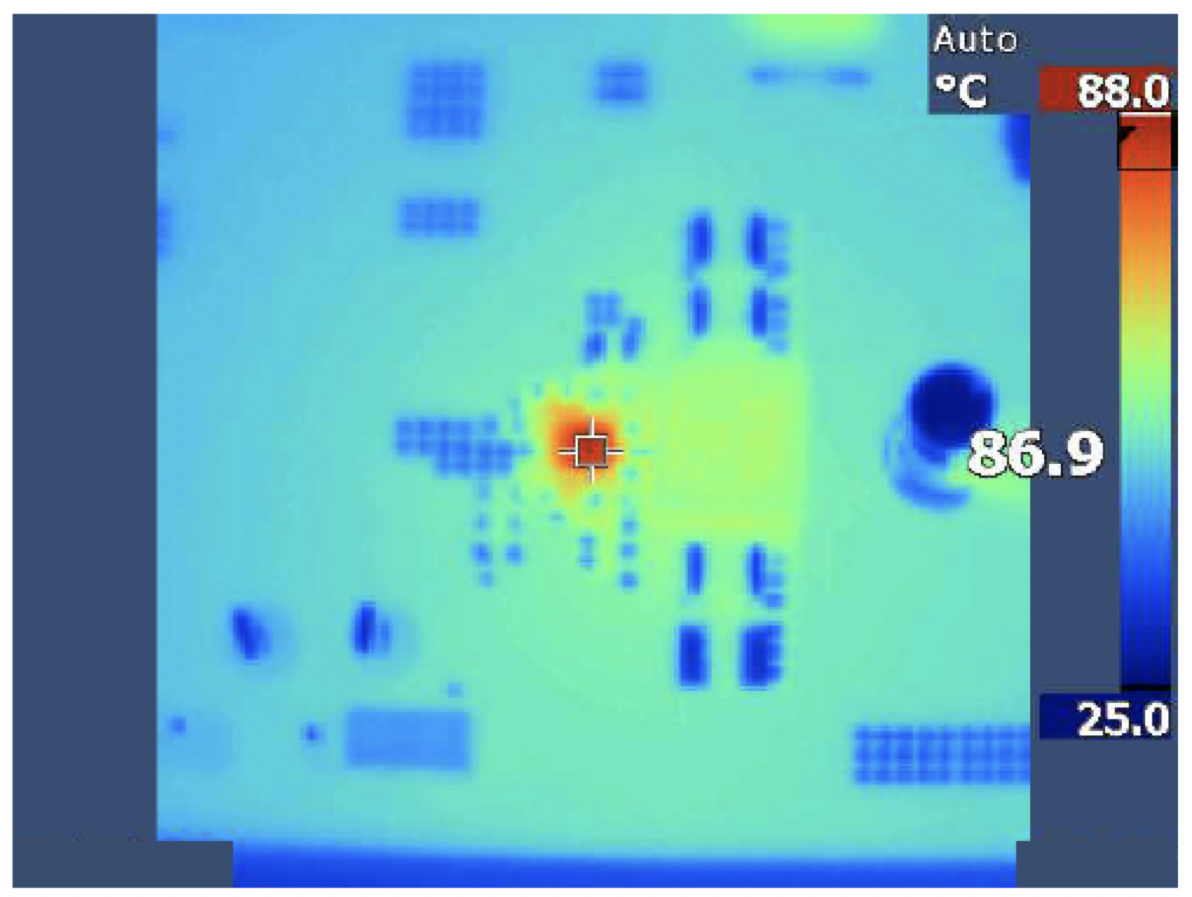 Abbildung 13 Wärmeverhalten eines
herkömmlichen HotRod-Gehäuses.
Abbildung 13 Wärmeverhalten eines
herkömmlichen HotRod-Gehäuses. Abbildung 14 Wärmeverhalten des LM60440 mit
DAP im Enhanced HotRod QFN-Gehäuse bei einer durchschnittlichen Temperatur von
71,1 °C.
Abbildung 14 Wärmeverhalten des LM60440 mit
DAP im Enhanced HotRod QFN-Gehäuse bei einer durchschnittlichen Temperatur von
71,1 °C.Darüber hinaus bevorzugen viele Entwickler oberflächenmontierte Gehäuse mit Small-Outline Transistor (SOT), da diese in der Regel kostengünstig sind und sich die Anschlussleitungen einfacher montieren lassen. TI hat verbesserte Prozesstechnologie und Schaltkreis-IP mit dem SOT-563-Gehäuse gekoppelt, sodass die geforderte höhere Stromdichte durch eine flache, zweireihige Anordnung der Pins ermöglicht wird. Ein aktuelles Beispiel ist der synchrone Abwärtswandler TPS566242 mit 3 bis 16 V. Das Gerät unterstützt bis zu 6 A Dauerstrom bei 98 % Tastverhältnis in einem SOT-563-Gehäuse (1,6 × 1,6 mm).
Auch bei Wafer-Chip-Scale-Gehäusen (WCSPs) wird der Großteil der Wärme direkt hinunter zur Leiterplatte geleitet. Je größer der Bump-Bereich in einem WCSP, desto besser ist die thermische Leistung. TI hat vor Kurzem ein PowerCSP™™-Gehäuse entwickelt und auf den Markt gebracht. Diese Art von Gehäusen soll durch Ersetzen der für WCSPs typischen kreisförmigen Bumps durch große Lötstäbe Wärmeverhalten und elektrische Leistung verbessern. Abbildung 15 zeigt die Umsetzung dieser Technologie im TPS62088. Abbildung 15 zeigt das Standard-WCSP-Gehäuse, in Abbildung 16 ist dagegen das gleiche Gerät mit einem PowerCSP-Gehäuse abgebildet. Es ist gut zu erkennen, dass der Temperaturanstieg ohne weitere Änderungen am System um etwa 5 % verringert wird.

| Vin = 5 V | Vout = 1,8 V |
| Iout = 3 A | TA = 25 °C |
| Messpunkt: Bx1 |
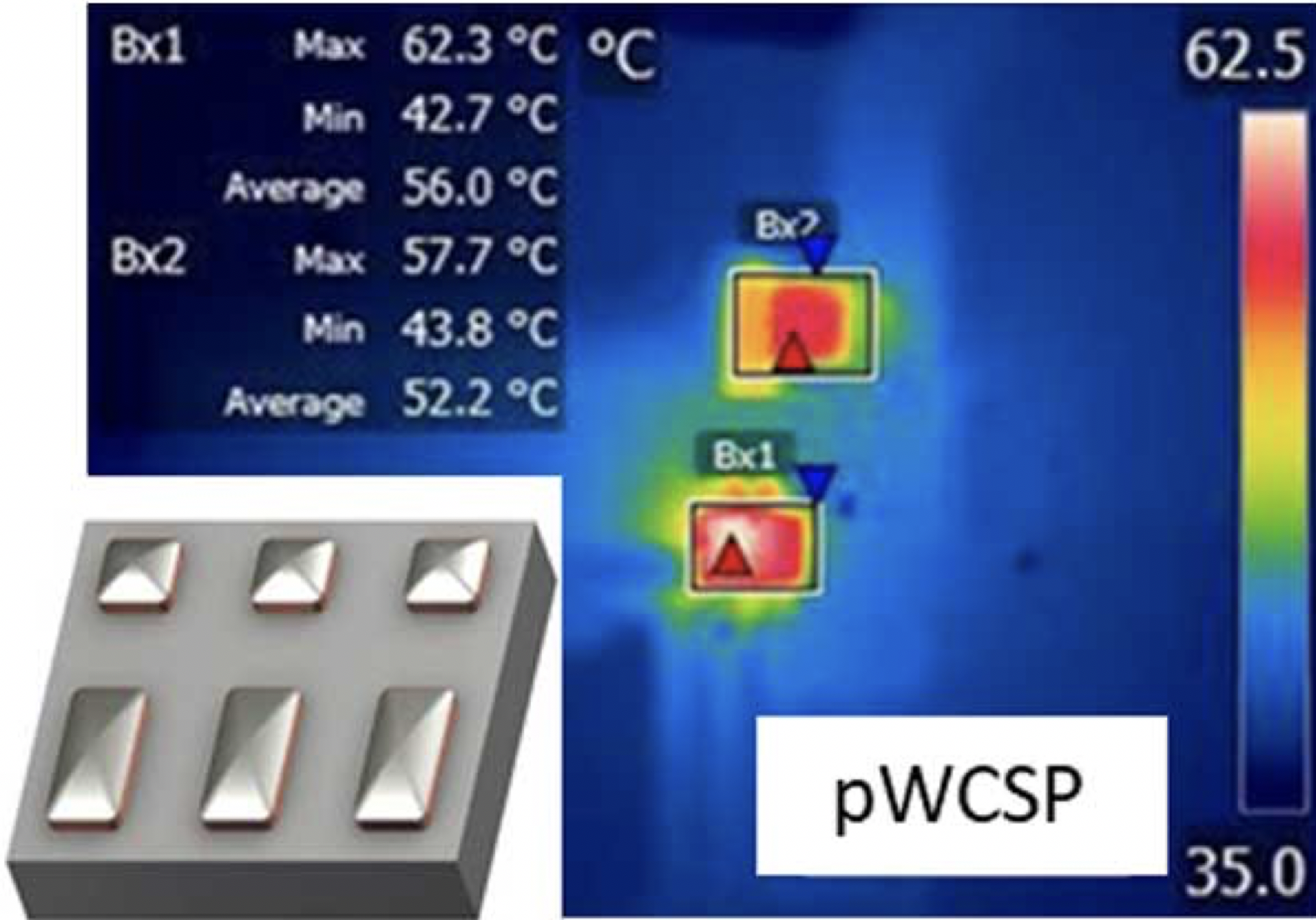
| Vin = 5 V | Vout = 1,8 V |
| Iout = 3 A | TA = 25 °C |
| Messpunkt: Bx1 |